集成电路(Integrated circuit, IC)一直是世界各国抢占的高地,也是国家综合国力的重要体现。随着IC在智能制造、穿戴设备的广泛应用,三维集成电路(3D IC)逐渐替代二维集成电路(2D IC)实现多芯片间系统的高度集成。当前,二维集成电路互连结构的直径大约为100μm,但是三维集成电路要求互连结构的直径缩小至5μm以下,对应的互连结构在芯片表面的分布密度将会增加104倍,体积也将缩小106倍。在这种高密度下,互连结构晶粒各向异性效应和晶界扩散机制带来的电迁移阻抗、热失效、剪切断裂等失效模式一直威胁3D IC的发展。
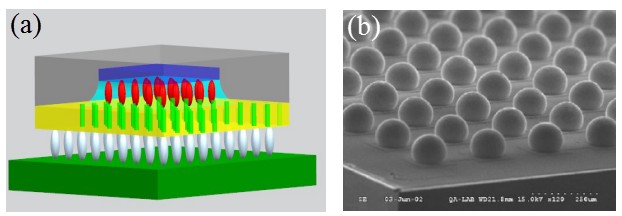

针对上述挑战,材料工程学院青年教师陈捷狮博士及指导的研究生开展了系列研究:开展锡(Sn)基钎料微合金化对微连互连结构的界面行为(界面生长/柯肯达尔效应(Kirkendall Effect)/力学性能测试等)研究,构建了微合金化界面生长模型,阐明了相应失效模式;开展芯片服役环境(热/电/腐蚀环境下)多重耦合作用下的互连结构微连接可靠行为研究;开展不同基板(多晶Cu/电镀Cu/真空溅射Cu/多晶Ni/单晶Ni)的互连结构界面微连接行为研究,阐明界面相形成机制,界面演化及剪切断裂等实效机理;根据前期基础,近期开展纳米化互连结构和单晶互连结构设计制备研究;相关成果发表了8篇SCI论文,其中二区论文2篇(Mater. Lett. (2020) 278, 128424(1-5); Appl. Phys. A-Mater. (2020) 126, 1-12; Mater. Today Commun. (2020) 24, 101182(1-10);J Mater. Res. Technol. (2019) 8, 4141-450, IF=5.289, 二区; J Alloy. Comp. (2019) 804, 538-548 IF=4.650, 二区; Weld. World (2019), 63,751-757 (71shIIW in Bali-Indonesia, Recommended for publication by Commission VII - Microjoining and Nanojoining); Phase Transit.( 2019) 1-17; Appl. Sci.-Basle (2018) 8, 2073(1-8)),并申请相关发明专利4项。其中Welding in the World (2019) 63(3) 751-757 在第71届国际焊接学年会(IIW)中(印度尼西亚•巴厘岛),被第七委员会(Commission VII)- “Microjoining and Nanojoining”专题推荐为最佳专题报告论文发表。
上述研究工作受国家自然科学基金(No. 51805316)、中国博士后科学基金面上资助(No. 2019M651491),先进焊接与连接国家重点实验室面上基金(No. AWJ-20-M12)和上海市激光先进制造技术协同创新中心资助。


